|
|
 |
如何設計加強產品的BGA焊墊強度以防止BGA開裂(SMD與NSMD焊墊設計的差異與優缺點)

隨著公司的產品從桌上型(Desktop)機種漸漸往手持式(Portable)產品移動,公司的產品也是越做越小,就連PCB也越做越薄,連帶的在設計及製造上所面臨到的挑戰也越來越高,尤其是BGA承受應力的能力要求越來越高。
最近工作熊碰到比較棘手的問題是【BGA開裂】,其實之前也有碰到過BGA開裂,只是當時把underfill(底部填充膠)加上之後問題就解決了,這次則是連underfill都給裂開了,在還沒找到BGA開裂的真正原因以前,新產品的設計也必須加強焊墊/焊盤的強度設計才行。
剛好板廠有在介紹這種【Solder-Mask-Defined (SMD)】防焊開窗限定焊墊大小的設計,可以加強BGA焊墊的強度,也可以減少焊墊整塊被BGA從FR4撕裂拉開的機率,現在就來看看PCB板廠建議如何設計這種SMD介紹吧!
一般PCB的焊墊/焊盤(pad)有兩種設計,一種是銅箔獨立為焊墊(pad),solder-mask(綠漆)的開窗大於焊墊,稱之為【Copper Defined Pad Design】或【Non-Solder-Mask-Defined,NSMD】,
![BGA焊殿(Cpper Defined Design)(Non-SolderMask Defined, NSMD) 一般PCB的焊墊/焊盤(pad)有兩種設計,一種是銅箔獨立為焊墊(pad),[solder mask]開窗大於pad,稱為【Copper Defined Pad Design】,這種焊墊設計的優點是焊錫性佳,因為在焊墊的三面都可以吃上錫,而且也可以精準的控制焊墊的位置與大小,另外走線(trace)也比較容易佈線。](https://www.researchmfg.com/wp-content/uploads/images/BGA-pad_EE62/BGA_copper-defined-design.png)
NSMD(Non-Solder Mask Defined)銅箔獨立焊墊
這種【Non-Solder-Mask-Defined,NSMD】焊墊設計的優點是焊錫性較佳,因為在焊墊的三面(表面及環側面)都可以吃到錫,而且也可以較精準的控制焊墊的位置與大小,另外layout工程師在走線(trace)時也比較容易佈線,因為焊墊尺寸相對比較小,trace可以輕易的通過BGA的焊墊與焊墊之間。

但是NSMD的缺點是焊墊銅箔比較容易被外力撕裂開來,因為焊墊較小,所以焊墊附著於電路板的力道也就相對較小。其次,焊墊的外型容易因為走線進出焊墊的多寡及大小而變形,進而影響到焊墊的大小及形狀。
這種BGA焊墊設計通常需要伴隨使用Underfill來加強落下測試(drop test)及滾動測試(Tumble test)時BGA承受外力的能力。
覆蓋於銅箔上並露出沒有被mask的銅箔形成焊墊(pad),這種焊墊設計稱為【Solder-mask Defined Pad Design】。](https://www.researchmfg.com/wp-content/uploads/images/BGA-pad_EE62/BGA_soldermask-defined-design.png)
SMD(Solder Mask Defined)防焊限定焊墊
另一種焊墊的設計是將solder-mask(綠漆/綠油)覆蓋於銅箔上並露出沒有被mask的銅箔來形成焊墊(pad),這種焊墊設計稱為【Solder-mask Defined Pad Design,SMD】。這種焊墊設計可以有效加強焊墊的強度(strength),並且強化落下測試(drop test)時的承受能力。依據板廠實驗測試結果,這種【Solder-mask Defined Pad Design】焊墊設計的拉力承受能力比【Copper Defined Pad Design】提昇了53%。
(請注意:這個實驗測試數據沒有植球,也就是純粹拉焊墊而已,如果要測試BGA錫球焊接後承受應力的能力,就必須要焊接後拉錫球才會比較客觀,請不要被這個數據誤導!)

但是,相對的SMD焊墊的缺點就是焊錫性會受到影響,因為Solder-Mask(綠漆)會受到回焊爐高溫的影響而膨脹,進而影響到錫膏的吃錫面積,另一個問題則是綠漆的印刷的位置定位比銅箔來得差,也就是綠漆印刷的偏差量比銅箔來的大多了,有可能會影響到焊墊的大小及相對位置。再來是因為銅箔的面積加大了,所以相對的可以走線的區域也就變小了,走線相對變得更困難。
不過,即使【Solder-mask Defined Pad Design】有這些焊錫性變差及走線變難的問題,對於手持式的產品還是很值得去賞試,畢竟這種設計可以提昇BGA整體的強度,提高信賴度,如果可以因此不用加點Underfill膠,那就完美了。
(請注意:工作熊個人對BGA焊墊設計應該採用SMD或NSMD的建議是需要依照個別產品而定,並沒有說那一種焊墊設計一定比較好,工作熊的部落格中有多篇文章探討這個議題,建議一定要把這些文章都翻出來參考一下,而不要單看一篇文章做決定!)
下面的圖片說明【Solder-mask Defined Pad Design】及【Copper Defined Pad Design】焊墊設計的拉力測試結果(155-101)/101=53%。
(請注意:這個測試沒有植球,也就是純粹拉焊墊而已,如果要測試BGA錫球焊接後承受應力的能力,就必須要焊接後拉錫球,請不要被這個數據誤導)

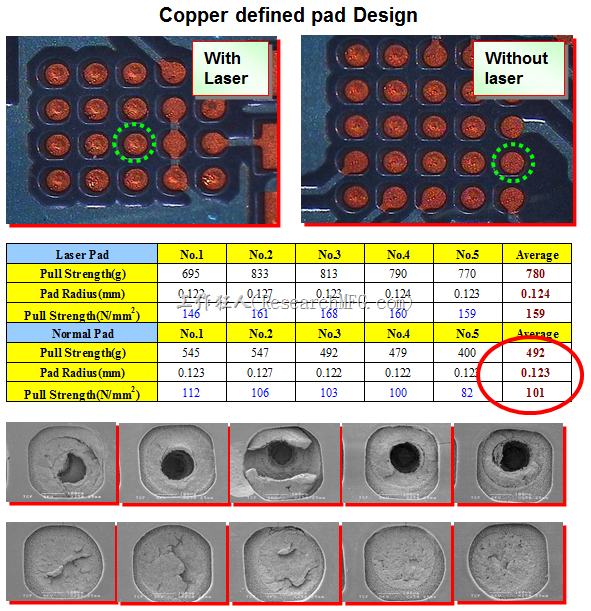
- With laser:表示BGA焊墊上設計有雷射導通孔(via)
- Without laser:表示BGA焊墊上無雷射導通孔(via)
BGA焊墊上有雷射導通孔的焊墊對抗拉力能力比無雷射導通孔優秀,但是導通孔必須要電鍍塞孔,否則SMT作業時錫量可能會不足造成空焊或是錫膏覆蓋住導通孔造成爆孔的問題。
部落格中其他與SMD及NSMD焊墊設計相關的文章:
延伸閱讀:
紅墨水染紅測試分析的允收標準
BGA枕頭效應(head-in-pillow)發生的可能原因
如何判斷BGA掉件是SMT工廠製程或是設計問題?
|
|
訪客留言內容(Comments)
前辈:
晚辈管中窥豹已久,受益颇丰,实属尔无名之师也!
今日得闲,偶遇其文,朵颐之下,岂不快哉!遥想当年小弟人轻言微,力荐RD顺之而为,而不得从,遂加胶而固之,后返修不易,弃而废之,惜之,叹之!
往事云烟逝,笑看眼前人!
见其文,有一事不明,请赐教!
拉之力,受之面,面之力,三者何为关联,其算法如何,还望详解!
抱歉,說明不完整
1.我剛剛想了一下,焊墊直徑0.25mm不變的前提下
採SMD開窗縮小,使PAD露出變為0.2mm(甚至更小),
似乎是沒有意義的行為(PAD過小問題會更多)
(不考慮焊墊脫落的情況)
2.此篇的重點是NSMD(焊墊脫落)>改採SMD(加強焊墊)(露出尺寸不變)
並不代表SMD比NSMD設計好,還是要看設計需求是什麼??
3.我現在遇到的是4x4mm QFN,中心焊墊2.6×2.6mm
前人採用SMD設計,製程端反映會有短路問題
我中心焊墊改採NSMD(或其他方式)目的是減少錫量
跟本文的設計目的不同,不能以本文判斷SMD設計比NSMD好
4.只要能解決問題,就是好的設計
抱歉剛剛沒詳細思考過就發問,希望我這樣的理解沒錯,謝謝
訪客留言注意事項:
1.首次留言須通過審核後內容才會出現在版面上,請不要重覆留言。
2.留言時請在相關主題文章下留言,與主題不相關的留言將會被視為垃圾留言,請善加利用【搜尋框】尋找相關文章,找不到主題時請在「水平選單」的「留言板」留言。
3. 留言前請先用【搜尋框】尋找相關文章,自己做一點功課後再留言。沒有前因後果的內容,工作熊不一定會瞭解你在說什麼,就更無法回答你的問題。
4. 工作熊並非某一方面的專家,所以回答的內容或許會有不正確的地方,服用前還請三思。如果您想詢問關於電路板方面的工程問題,請前先參考這篇文章【詢問工程問題,請提供足夠的資訊以利有效回答】 把自己的問題想清楚了再來詢問,並且請提供足夠的資訊,這樣才能有效回答問題。
5. 工作熊每則留言都會看,但不會每則留言都回答,尤其是只有問候之類的內容。
6. 留言詢問時請注意您的態度,工作熊不是你的「細漢」,更沒有拿你的薪水,所以不接受吆喝工作熊的態度來回答你的問題。
7. 原則上工作熊不接受私下電子郵件、電話、私訊、微信或任何即時通聯絡。
8. 自2021年7月起Google將停止最新文章電子郵件通知,如果你想隨時接收部落格的最新文章可以參考這裡。







你好,关于你上面所展示的两组拉力测试数据我不是很理解,with laser和without laser指的是什么意思,两者有什么区别?能否麻烦介绍一下,谢谢了。