|
|
 |
SMT發生BGA枕頭效應(head-in-pillow,HIP)的可能原因與機理

枕頭效應(Head-in-Pillow, HIP)的不良現象看起來就類似一個人把頭虛靠放在枕頭上的形狀而得名,而不是埋進枕頭內,所以最近開始有人將之稱為HoP(Head-on-Pillow),而不論是HIP或HoP兩者指的都是BGA錫球焊點的虛焊(non-wetting)不良現象。工作熊個人覺得它的有些現象看起來反而像是脖子或是腰身,但工作熊覺得稱呼其為【雙球現象】似乎更為恰當。
枕頭效應(Head-in-Pillow,HIP)最主要的形成原因為電路板的BGA零件在回焊(Reflow)的高溫過程中,BGA載板或是電路板因受不了高溫而發生板彎、板翹(warpage)或是其他原因變形,使得BGA的錫球(ball)與印刷在電路板上的錫膏分離,當電路板經過高溫「回焊區(reflow zone)」後溫度漸漸下降冷卻,這時IC載板與電路板的變形量也慢慢回復到變形前的狀況(有些情況下變形會回不去),但這時的溫度早已低於錫球與錫膏的熔錫溫度了,也就是說錫球與錫膏早就已經從熔融狀態再度凝結回固態。當BGA的載板與電路板的翹曲慢慢恢復回到變形前的形狀時,已經變回固態的錫球與錫膏才又再次互相接觸,於是便形成類似一顆頭虛靠在枕頭上的虛焊或假焊的焊接形狀。
(對於中國大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
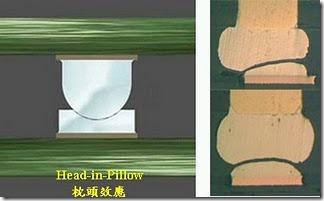 這類因為板彎而造成的HoP/HIP不良為最大宗,而且這類不良也大多分佈在BGA封裝的四個角落位置,因為方形封裝的BGA在對角線的距離是最長的,板彎的變形量也最大。另外,還有一些分佈在BGA封裝其他位置的HoP/HIP不良,在文章後面也會稍加討論。
這類因為板彎而造成的HoP/HIP不良為最大宗,而且這類不良也大多分佈在BGA封裝的四個角落位置,因為方形封裝的BGA在對角線的距離是最長的,板彎的變形量也最大。另外,還有一些分佈在BGA封裝其他位置的HoP/HIP不良,在文章後面也會稍加討論。
如何檢測HIP(Head-In-Pillow)焊接不良
依照上述的理論,枕頭效應(HIP)大部分應該都會發生在BGA零件的邊緣,尤其是四個角落的位置,因為那裏的翹曲最為嚴重,如果是這樣,就可以試著使用顯微鏡或是光纖內視鏡來觀察,但通常這樣只能看到最外面的兩排錫球,再往內就很難辨認了,而且這樣觀察BGA的錫球還得確保其旁邊沒有高零件擋住視線,以現在電路板的高密度設計,執行起來限制頗多。
 |
 |
另外,枕頭效應(HIP)一般也很難從現在的2D X-Ray檢查機發現得到,因為X-Ray大多只能由上往下檢查,看不出來BGA錫球斷頭的位置,如果可以有上下旋轉角度的X-Ray應該可以觀察得出來。有些時候或許可以經由板內測試(ICT, In Circuit Test)及功能測試(FVT, Function Verification Test)檢測出來,因為這類機器通常使用針床的作業方式,需要添加額外的外界壓力於電路板上,讓原本互相挨著的錫球與錫膏有機會分開,但還是會有許多的不良品流到市場,通常這類不良品很快的就會被客戶發現有功能上的問題而遭到退貨,所以如何防治枕頭效應的發生實為SMT的重要課題。
另外,也可以考慮透過燒機(Burn/In)的方式來篩選出有HIP的板子(如果單板燒機要加溫度),因為燒機的時候會有升高板子的溫度,溫度會讓板子變形,板子有變形,空/假焊的焊點就有機會浮現出來,所以燒機的時候還得加上程式作自我診斷測試,如果HIP的位置不在程式測試的線路上,就查不出來了。
(對於中國大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
目前比較可靠可以分析HIP不良現象的方法是使用染紅試驗(Red Dye Penetration),以及微切片分析(Cross Section),但這兩種方法都屬於破壞性檢測,所以非到必要不建議使用。
新近【3D X-Ray CT】的技術有了突破,可以有效的檢查到這類HIP或是NWO(Non-Wet-Open)焊接缺點,而且也慢慢普及了起來,但機台的費用還是不夠便宜就是了。
發生HIP(Head-In-Pillow)的幾個可能原因與機理
枕頭效應雖然是在回流焊期間所發生的,但其真正形成枕頭效應的原因則可以追溯到材料不良,而在電路板組裝工廠端則可以追溯到錫膏的印刷,貼件/貼片的準確度及迴焊爐的溫度設定…等。
底下是幾個形成枕頭效應(HIP)缺點的可能原因:
-
BGA封裝(Package)
如果同一個BGA的封裝有大小不一的焊球(solder ball)存在,較小的錫球就容易出現枕頭效應的缺點。
另外BGA封裝的載板耐溫不足時也容易在迴流焊的時候發生載板翹曲變形的問題,進而形成枕頭效應。
warpage of substrate, inconsistent bump size)

-
錫膏印刷(Solder paste printing)
錫膏印刷於焊墊上面的錫膏量多寡不一,或是電路板上有所謂的導通孔在墊(Vias-in-pad),就會造成錫膏無法接觸到焊球的可能性,並形成枕頭效應。
另外如果錫膏印刷偏離電路板的焊墊太遠、錯位,這通常發生在多拼板的時候,當錫膏熔融時將無法提供足夠的焊錫形成橋接,就會有機會造成枕頭效應。
(insufficient solder paste volume, printing misalignment)
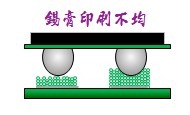

-
貼片機的精度不足(Pick&Place)
貼片機如果精度不足或是置件時XY位置及角度沒有調好,也會發生BGA的焊球與焊墊錯位的問題。
另外,貼片機放置IC零件於電路板上時都會稍微下壓一定的Z軸距離,以確保BGA的焊球與電路板焊墊上的錫膏有效接觸,這樣在經過迴流焊時才能確保BGA焊球完美的焊接在電路板的焊墊。如果這個Z軸下壓的力量或形成不足,也有機會讓部份焊球無法接觸到錫膏,而造成HIP的機會。
(Inaccurate XY placement, insufficient placement force)


-
回流焊溫度(Reflow profile)
當回流焊(reflow)的溫度或升溫速度沒有設好時,就容易發生沒有融錫或是發生電路板及BGA載板板彎或板翹…等問題,這些都會形成HIP。可以參考BGA同時空焊及短路可能的原因一文,瞭解BGA載板與電路板因為CTE的差異過大,以及TAL(Time Above Liquids)過長,而造成的板彎板翹所形成的BGA空焊及短路的分析。
另外,要注意預熱區的溫度升溫如果太快的話容易驅使助焊劑過早揮發,這樣就容易形成焊錫氧化,造成潤濕不良。其次最高溫度(Peak Temperature)也最好不要調得過高及過久,建議最好參考一下零件的溫度及時間的建議。
(inadequate reflow profile that results in component & PCB warpage, Lifting of BGA bumps due to wetting force, Excessive Peak Temperature, too much TAL)

-
焊球氧化(Solder ball Oxidation)
BGA在IC封裝廠完成後都會使用探針來接觸焊球作功能測試,如果探針的潔淨渡沒有處理的很好,就有機會將污染物沾污於BGA的焊球而形成焊接不良。
另外,BGA的錫球如果在封裝廠有過不當重工,可能造成部份錫球的助焊劑提前揮發,於SMT回焊時造成潤濕不良。其次,如果BGA封裝未被妥善存放於溫濕度管控的環境內,也很有機會讓焊球氧化至影響焊錫的接合性。
(對於中國大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
如何改善與防止HIP(Head-In-Pillow)焊接不良
既然已經知道HIP形成的原因最主要來自電路板的FR-4以及IC載板高溫變形,所以要防止或避免HIP發生就有兩個方向可以進行。
-
方法一是提高電路板板材及IC載板的剛性。採用較高(Tg ≥ 170℃)的材料可以增加剛性,不過費用也會跟著提高。一般無鉛製程採用的印刷電路板的材質大多僅使用中Tg(Tg ≥ 150℃)。
相關閱讀:何謂玻璃轉移溫度(Tg, Glass Transition Temperature) -
方法二是增加錫膏量來填補電路板及IC載板因為高溫翹曲所形成的間隙,也就是在所有的回焊過程中讓BGA錫球與印刷在電路板上的錫膏都保持接觸的狀態,不過要小心錫膏量如果增加太多反而會造成焊接短路的問題,不可不慎。
更多HIP(Head-In-Pillow)焊接不良的改善方法可以繼續參考下列文章:
延伸閱讀:
影片:BGA 回流焊焊接過程
BGA錫球缺點的幾種檢查方法
如何判斷BGA掉件是SMT工廠製程或是設計問題?
為何產品執行燒機(B/I)也無法攔截到DDR虛焊的問題?
BGA虛焊NWO(Non-Wet-Open)形成的原因及可能解決方法
|
|
訪客留言內容(Comments)
這几天看了熊大大的部落格裡面的工藝資料,敘述的很詳細,圖文并茂,
偶在SMT做工藝也有好多年了,許多東西都要加強,
我SMT HOME 也有一個賬號 KS706
就是您發的一個關於QFN分析的鏈接,偶就跑過來學習了,呵!
熊Sir,
关于导致BGA类元件(如CPU)HIP问题的因素,个人觉得 回焊炉的密封性应该也是一个关键点。
回焊炉密封性差,氧含量超过1000ppm时,氮气气氛对锡膏及锡球的润湿性改善效果降低,导致soldering issue.提出来跟你分享讨论下~
訪客留言注意事項:
1.首次留言須通過審核後內容才會出現在版面上,請不要重覆留言。
2.留言時請在相關主題文章下留言,與主題不相關的留言將會被視為垃圾留言,請善加利用【搜尋框】尋找相關文章,找不到主題時請在「水平選單」的「留言板」留言。
3. 留言前請先用【搜尋框】尋找相關文章,自己做一點功課後再留言。沒有前因後果的內容,工作熊不一定會瞭解你在說什麼,就更無法回答你的問題。
4. 工作熊並非某一方面的專家,所以回答的內容或許會有不正確的地方,服用前還請三思。如果您想詢問關於電路板方面的工程問題,請前先參考這篇文章【詢問工程問題,請提供足夠的資訊以利有效回答】 把自己的問題想清楚了再來詢問,並且請提供足夠的資訊,這樣才能有效回答問題。
5. 工作熊每則留言都會看,但不會每則留言都回答,尤其是只有問候之類的內容。
6. 留言詢問時請注意您的態度,工作熊不是你的「細漢」,更沒有拿你的薪水,所以不接受吆喝工作熊的態度來回答你的問題。
7. 原則上工作熊不接受私下電子郵件、電話、私訊、微信或任何即時通聯絡。
8. 自2021年7月起Google將停止最新文章電子郵件通知,如果你想隨時接收部落格的最新文章可以參考這裡。







Hi,
Is there any inspection system can detect Head-in-Pillow effect? You did mentioned that using Red Dye Penetration Test and Cross Section are the most accurate but they are destructive tests. So is there any other tests can detect or inspect Head-in-Pillow effect on the board before we send the board for Red Dye Penetration or Cross Section.
Thanks.