|
|
 |
Underfill(底部填充劑)的目的與操作程序

底部填充劑(Underfill)原本是設計給覆晶晶片(Flip Chip)使用以強化其焊點的機械強度並增強其信賴度用的製程與膠水。
因為矽材料做成的覆晶晶片的熱膨脹係數(CTE)遠比一般基板(PCB)材質低很多,因此在熱循環測試(Thermal cycles)中常常會有相對位移產生,導致機械疲勞而引起焊點脫落或斷裂的問題,後來這項Underfill技術被廣泛運用到了一些BGA晶片底下以強化其焊接強度,並提高焊接於電路板後的落下/摔落時的可靠度。
底部填充劑的材料通常使用環氧樹脂(Epoxy),它利用毛細作用原理將 Epoxy塗抹在晶片的邊緣讓其自動滲透到覆晶晶片或BGA的底部,然後再加熱予以固化(cured)。因為它能有效提高焊點的機械強度,從而提高晶片的使用壽命,所以目前大多被運用在一些手持裝置,如手機的電路板設計之中,因為手持裝置必須要通過嚴苛的裸機跌落試驗(Drop test)與滾動試驗(Tumble test),很多BGA的焊點幾乎都無法承受這樣的嚴苛測試條件,尤其是一些ENIG表面處理的板子。
建議延伸閱讀:如何決定BGA底部填充膠(underfill)需不需要填加?
添加底部填充劑的步驟通常會被安排在電路板組裝完成,也就是完成 SMT、Wave Solder、手焊零件,並且完全通過電性測試後確定板子的所有功能都沒有問題了才會執行,因為執行了underfill之後的晶片就很難再對其進行修理(repair)或重工(rework)的動作。
(對於大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
 底部填充劑添加之後還需要再經過高溫烘烤以加速環氧樹脂的固化時間,另外也可以確保晶片底下的充填劑真的固化,一般環氧樹脂擺放在室溫下雖然也可以慢慢的固化,但至少需要花費24小時以上的時間,根據與空氣接觸的時間長短而有所不同,有些環氧樹脂的成份裡面還會添加一些金屬元素的添加劑,選用的時候必須要留意其液態及固態時的表面阻抗,否則有機會產生漏電流(current leakage)問題。
底部填充劑添加之後還需要再經過高溫烘烤以加速環氧樹脂的固化時間,另外也可以確保晶片底下的充填劑真的固化,一般環氧樹脂擺放在室溫下雖然也可以慢慢的固化,但至少需要花費24小時以上的時間,根據與空氣接觸的時間長短而有所不同,有些環氧樹脂的成份裡面還會添加一些金屬元素的添加劑,選用的時候必須要留意其液態及固態時的表面阻抗,否則有機會產生漏電流(current leakage)問題。
添加底部填充劑時一般只會在晶片的相鄰兩邊進行L型的路徑填加環氧樹脂。
底下是使用 Loctite 3536 操作 Underfill 的一些步驟,僅供參考:
-
Loctite 3536 必須儲存與於5℃的低溫(Loctite 要求溫度需介於2℃~8℃,之間),灌膠以前必須將之回到室溫至少 1 個小時才可使用。
- 灌膠時需要將待 Underfill 的電路板預熱到 70℃。
-
等待約30~60秒的時間,待 Loctite 3536 滲透到BGA底部。
-
給 BGA 晶片在做第二次 L型路徑點膠,膠量要比第一次少一點,等待約60秒左右,觀察黑膠有否擴散到 BGA 的四周並形成斜坡包覆晶片。(此目的在確保晶片底下的 underfill 有最少的氣泡或空洞)
-
確認灌膠無誤後將灌好膠的電路板放進烤箱,烤到130℃ + 20分鐘。 (Loctite不建議140℃ 以上的溫度烘烤)
-
烘烤後,檢查灌膠的外觀是否黑亮,用指甲輕觸並感覺是否光滑堅硬。
延伸閱讀:
製造工廠的MRB會議及塑膠件品質判斷
簡介電路板組裝後的功能測試(FVT/FCT)
COB Epoxy灌膠時氣泡產生的原因與解決方法
防潮絕緣抗腐蝕漆、電路板表面被覆/塗布(Conformal coating)三防漆
|
|
訪客留言內容(Comments)
我们现在在用loctite 3593的胶水,点胶方式为L形,BGA为15*15MM,PCA点胶前加热到90-100度,点胶时也维持此温度,点胶后又放置10分钟以上,BGA两边上都有胶,但是对角的还有4*4MM没有填充满。做切片后发现有很多气泡,请指教。
Plasma有 RF與MW兩大類, 在FlipChip underfill process, Taiwan的廠商會用MW, 利用測吹的方式將Plasma吹入gap, 依據Plasma廠商之前的report, 在100um gap時, 可以吹入13mmx13mm的package. 但underfill不是因為gap下有被吹到而流的快, 是因為package側邊有被吹到, 所以underfill由側邊帶動, 造成有比較多與較快的波前面, 所以才流的比較快. 因此韓國的廠商就改用RF type的, 電漿流從上面往下打, 有洗到package的側邊就可以了.
我知道BGA的灌膠不同一般的填注, 是用毛細現象來流動, 而underfill流動的公式可在網路上查, 流動時間=(3*黏度*流動距離^2)/(表面張力*gap*接觸角), 所以應該要先跟廠商拿Viscosity-temperature-time 曲線, 才知道在幾度c點時才流的快.而Plasma的用處是改變接觸角, RF是藉由粗糙度, MW是改變表面能, 都是用來改變underfill的接觸角
想請教工作熊,目前有沒有什麼方法可以量測Underfill的黏著力呢?
之前本來想使用類似拔die的方式進行,但是拔IC的力度會遠大於量測機台可量測的數據.
因此苦惱於不知如何把Underfill的黏著力使用量化的方式呈現.
謝謝.
工作熊,你好!
aaron问有没有能经过二次回流的Underfill胶,目前已经有了,这种胶水的Tg点要求很高,通常都是难于返修的。
我司的产品已经研发成功。但目前碰到以下难题,主要还是施胶工艺方面出现的问题。
1、使有这种胶水的通常都是芯片模组,有多个芯片需要施胶作业,因为模组的布局非常紧凑,又有屏蔽框架的影响,施胶轨迹难于顺利规划,频繁断点施胶容易造成空洞,进而在回流时因为空洞造成连锡、跑锡、爆锡的的情况
2、在布局紧凑的板面上还密集分布着电阻感容等器件,因为底部填充胶的特性,在施胶时难免会扩散到这些器件上面或者边沿,那么在过回流焊时,未包完整包覆的焊料,也会出现爆锡连锡的不良。
您好,據了解覆晶封裝已經漸為趨勢, 所以想請教您一般使用的是轉注成型的機台?還是壓縮成型的機台呢? (小的在賣清模材料,因為今年出貨下降正被原廠追問中,我的產品好像僅用在轉注成型上) 在麻煩您了感謝您!
訪客留言注意事項:
1.首次留言須通過審核後內容才會出現在版面上,請不要重覆留言。
2.留言時請在相關主題文章下留言,與主題不相關的留言將會被視為垃圾留言,請善加利用【搜尋框】尋找相關文章,找不到主題時請在「水平選單」的「留言板」留言。
3. 留言前請先用【搜尋框】尋找相關文章,自己做一點功課後再留言。沒有前因後果的內容,工作熊不一定會瞭解你在說什麼,就更無法回答你的問題。
4. 工作熊並非某一方面的專家,所以回答的內容或許會有不正確的地方,服用前還請三思。如果您想詢問關於電路板方面的工程問題,請前先參考這篇文章【詢問工程問題,請提供足夠的資訊以利有效回答】 把自己的問題想清楚了再來詢問,並且請提供足夠的資訊,這樣才能有效回答問題。
5. 工作熊每則留言都會看,但不會每則留言都回答,尤其是只有問候之類的內容。
6. 留言詢問時請注意您的態度,工作熊不是你的「細漢」,更沒有拿你的薪水,所以不接受吆喝工作熊的態度來回答你的問題。
7. 原則上工作熊不接受私下電子郵件、電話、私訊、微信或任何即時通聯絡。
8. 自2021年7月起Google將停止最新文章電子郵件通知,如果你想隨時接收部落格的最新文章可以參考這裡。

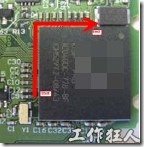







您好~~看你的文章讓我收穫很多。
想請教一個問題,我們在點underfill的時候,也是採用L型的點膠路徑,但是發現underfill沒有辦法完全擴散到BGA的四周,必須在另一端的L型再點一次,可是這樣的用量太多了,畢竟一管underfill價格很貴,想請教有什麼改善方式,我們家的PE是認為,此underfill黏性太黏,所以不容易擴散,想請教您的看法如何??
謝謝